インターコネクト・アドバンスト・テクノロジー(ICAT)共同研究プロジェクト Joint Research Project on Interconnect Advanced Technology
 小池 淳一特任教授
Specially Appointed Prof. Junichi Koike
小池 淳一特任教授
Specially Appointed Prof. Junichi Koike
研究の概要
高速で動作する先端半導体デバイスにおいて、トランジスタに接続するインターコネクトは、微細化の進行に伴って電気抵抗と電流密度が急激に増大し、デバイス性能と信頼性が劣化します。しかし、これらの課題を克服できる配線材料はまだ見出されていません。本プロジェクトは、2nm以降の最先端技術世代において優れた性能と信頼性を有する新材料の開発と、新材料を用いたプロセス条件の開発を行うことで、インターコネクト関連の課題を解決することを目指しています。
研究の特色
先端半導体デバイスに使用されている材料や製造工程を知ることなしに、インターコネクトの課題も知ることができません。しかし、これらの正確な情報は公開されることがないため、推測による課題設定をせざるを得ないのが現状です。本研究では、デバイスメーカーはもとよりサプライチェーンにある各メーカーとの共同研究を通じて課題を明確に把握し、タイムリーに解を提供することを可能としています。研究開発の背景にある学理は金属材料工学であり、熱力学計算によって材料の予備選定や反応挙動の予測を行い、さらに実験によって確認します。また、量子力学計算による特性予測なども活用して、開発方針の立案やメカニズムの解明に役立てます。
期待される成果・展開先
先端半導体デバイスは、自動運転の実現や生成AIの進化など、私達の生活様式に大きな変革をもたらす基幹製品です。しかし、インターコネクトに関わる課題が次世代の半導体デバイス開発のボトルネックになっています。トランジスタに接続して信号を伝達するインターコネクトは、電界効果トランジスタが開発されて以来30年間はアルミニウム配線、その後現在に至るまで25年間は銅配線が利用されてきました。しかし、デバイスが微細化することによって銅本来の特性が得られなくなり、信頼性の課題も懸念されています。本研究で探索している新材料は、銅配線の課題を解決し、銅の次にくる配線材料として今後長期間利用されることを狙っています。得られる成果物は、新配線材料、新配線材料に関連する製造工程、および新配線材料を用いた先端半導体デバイスです。これらの成果を利用することで、新しい情報時代の到来に貢献できると期待しています。
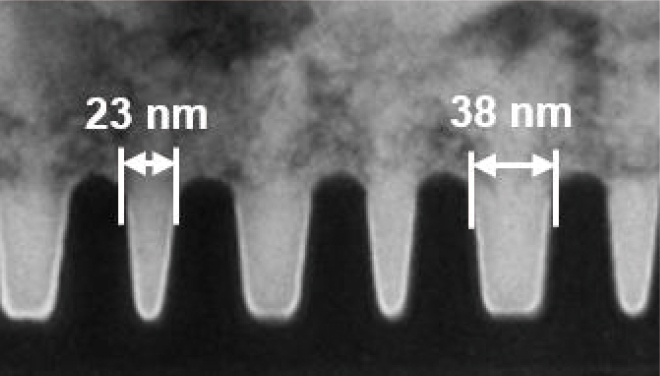
ダイナミックリフロー法によるCuAl2配線の形成。微細な配線溝を形成した基板を250℃に加熱し、スパッタ法で配線材料を埋め込んだ。
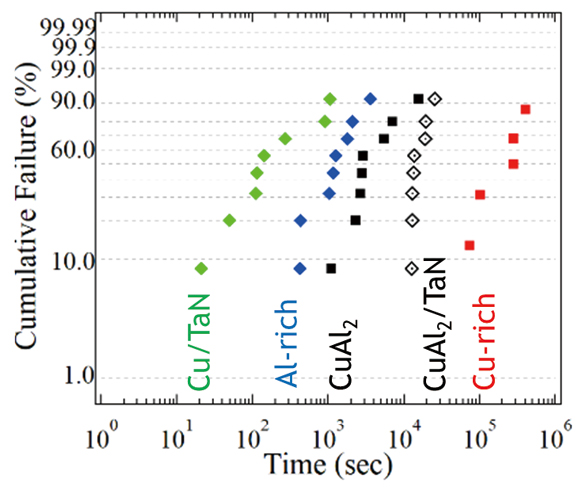
従来のCu配線(Cu/TaN)と新配線材料のエレクトロマイグレーション寿命の比較。新材料の寿命は10~1000倍長い。
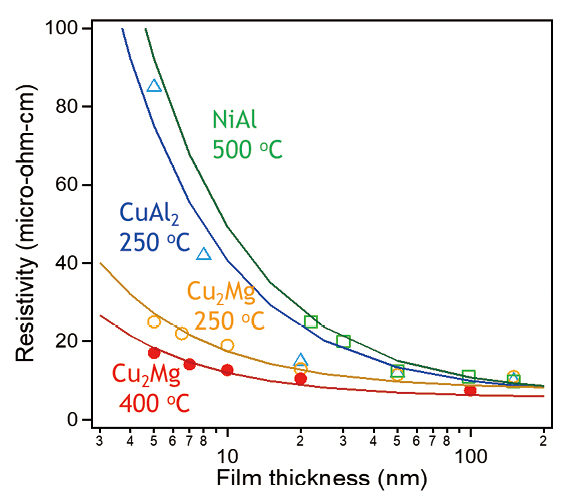
膜厚の減少に伴う新配線材料の電気抵抗増加の様子。線幅が10nm以下の細線の抵抗率がCuより低いことが求められる。
