ホリスティック三次元集積半導体開発とオープンイノベーション拠点の構築 Center for Holistically Integrated and Packaged Systems (Tohoku CHIPS)
 福島 誉史教授
Prof.
福島 誉史教授
Prof. Takafumi Fukushima
研究の概要
先駆的に東北大学で誕生した三次元積層型集積回路(3D-IC)とチップレット技術を基軸とし、30年近くにわたり蓄積された先端半導体実装工学(Advanced Microelectronic Packaging Engineering)を駆使した次世代半導体システムの集積化に関する研究開発を行います。個々のコンポーネントの性能を高める「要素論的な集積」に加え、チップ間配線や実装方式、放熱設計などまで含めて総括的にシステムを俯瞰した「全体論的な集積」に焦点を当てた技術開発、試作研究を特長とします。
研究の特色
大学発スタートアップの東北マイクロテック社と共同運営する三次元スーパーチップLSI試作製造拠点GINTI「ジンティ」(Global INTegration Initiative)では、半導体研究開発のスタンダードである直径200-300mmのSiウエハを使って3D-ICを柔軟に作製できます。それに加えて、世界でも例の無いダイレベルやマルチチップレベルの三次元実装を用いた「3D-ICのラピッドプロトタイピング」を実現できる技術で他と差異化します。本プロジェクトでは、唯一無二の試作拠点GINTIのさらなる「オープンイノベーション拠点化」も目指し、国内外の産官学との連携を強化して我が国の半導体復興の一躍を担います。
期待される成果・展開先
2D-ICチップにSi貫通配線(TSV: Through-Si Via)を形成して3D-IC化する技術や、光電子集積などのHeterogeneous Integrationを通じて、業界で最重要視される半導体前工程と後工程を融合する「中工程」領域を開拓し、設計、材料、プロセス、信頼性解析等の技術基盤を構築します。これによって集積回路内部だけでなく、集積回路外部のパッケージ基板やそれらをつなぐインターポーザ(中継基板)を含めた半導体システム全体の高性能化と多機能化が促進されます。また、ロジックチップの三次元集積だけでなく、デジアナ混載チップや三次元AIチップなど革新的な3D-ICの機能検証が短期間で実証でき、新しいアーキテクチャの導入も加速されます。さらに、チップレットの超並列アセンブリなど多品種大量生産に資する技術を実用レベルに仕上げ、異種デバイスの集積化を進展させます。これらを通して、日本の半導体産業の裾野をさらに広げ、人材育成にも貢献し、メガファブだけに占有されない半導体市場創出の一助となることが期待できます。
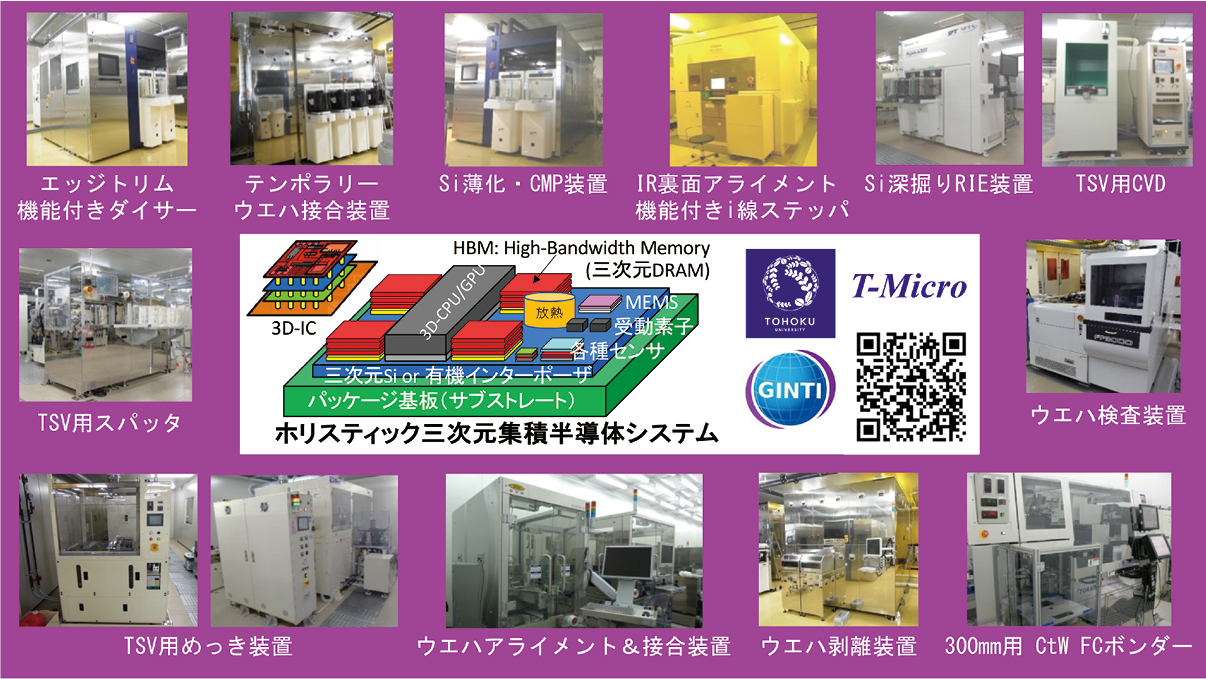
ホリスティック三次元集積半導体システムの概念図と300mmウエハを用いた3D-ICの一貫製造ラインを整備するGINTIの装置群
未来の産業を担う三次元積層半導体(3D-IC)の現況と今後の展開―東北大学3D-IC研究開発拠点「GINTI」の活動成果より―
https://youtu.be/3zPtmCtSOJg
興味があれば、ご視聴ください。
